IC-substrat
Ny generation av ultra HDI-kretskort
IC-substrat, liksom kretskort (SLP), flyttar fram gränserna mellan HDI kretskortsteknik och IC-substratsteknik. SLP är en integrerad del av IC-förpackningen eller modulen som används för att ansluta chipet till kretskortsmoderkortet. SLP:s teknikutveckling drivs främst av mobiltelefonindustrin och industrin för bärbara elektroniska enheter, och det är en snabbt växande marknad.
Produktfördelar
IC-substratkortets huvudfunktioner omfattar lödning av chip och elektrisk anslutning genom trådbindning eller flip-chip-process, och det garanterar tillförlitlighet genom att använda anpassat råmaterial för chipförlängning. Tillförlitligheten garanteras genom att använda råmaterial som är anpassade till de olika materialens töjning under monteringsfaserna och klimatbegränsningarna.

Hög densitet
Substratliknande kretskort (SLP) tar HDI-kretskortstillverkning till en ny nivå med ultrafin linje/rymd ner till 30/30 µm. Enligt vanliga färdplaner för SLP Manufactories förväntas man nå line/space 20/20µm år 2024 och 10/10 år 2025.

Tillförlitlighet
Substratliknande kretskort (SLP) baseras på BT-hartsmaterial (Bismaleimide Triazine) istället för FR4. BT-materialet har en mycket hög Tg. 250 till 300 °C och en mycket låg X&Y CTE 2-5 ppm/°C istället för 11-14 ppm/°C för FR4. Detta ger en mycket tillförlitlig integration med IC-substraten och gör det möjligt att skapa moduler eller SIP-system (Systems in Packages) med chip eller komponenter med hög densitet.

Prestanda
SLP-tekniken använder högpresterande material, processen för IC-substrat och de stack-ups med laserdefinierade vias som är kända från HDI-tekniken för att skapa ett mycket tillförlitligt och ultrakomplext HDI-kretskort.
Vad är IC-substratkretskort?
Definition
Ett IC-substratliknande kretskort (SLP), även kallat IC-hållarkort, är en typ av kretskort som är särskilt utformat för att hålla integrerade kretsar (IC). Det är ett ultra HDI-kretskort som används inom halvledarindustrin för att paketera och ansluta IC-chip till resten av det elektroniska systemet.
Huvudfunktionen för ett kretskort med IC-substrat är att tillhandahålla en fysisk plattform för montering och sammankoppling av IC-chip. SLP har vanligtvis 2-6 lager av ledande spår, laserdefinierade vias och kontaktytor som möjliggör elektriska anslutningar mellan både IC-chipen och kretskortet.

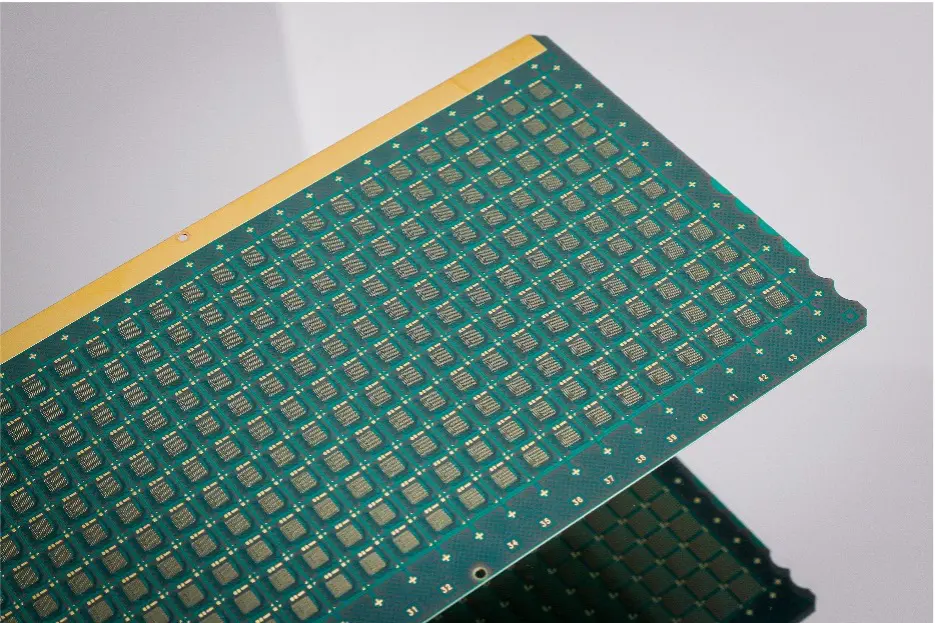
Specifikationer
Linje och rymd: 30/30 µm (avancerat 20/20 µm)
Vias: 50µm laserdefinierad.
Antal lager: 2 till 6
Kretskortmaterial: BT-harts, bismaleimidtriazin
Struktur för IC-substrat
Det finns 3 olika processmetoder.
Subtraktiv metod – subtraktiv process med tunna kopparplåtar på 9–12 µm och produktionssteg baserade på panel tenting-metoden. 35/35µm Line & Space möjligt.
mSAP – En modified semi additive process: en modifierad semiadditiv process med ett 1,5 µm tunt kopparblad, en kemisk kopparplätering + selektiv kopparbeläggning och selektiv etsning. 20/20 µm Line & Space möjligt.
SAP – Semiadditiv process: en semiadditiv process med ett speciellt material utan kopparbas och en kemisk kopparplätering + selektiv kopparbeläggning och selektiv etsning. 15/15 µm Line & Space möjligt. (SAP-metoden kan skapa upp till 12 lager, men den är endast tillgänglig för masstillverkning.)

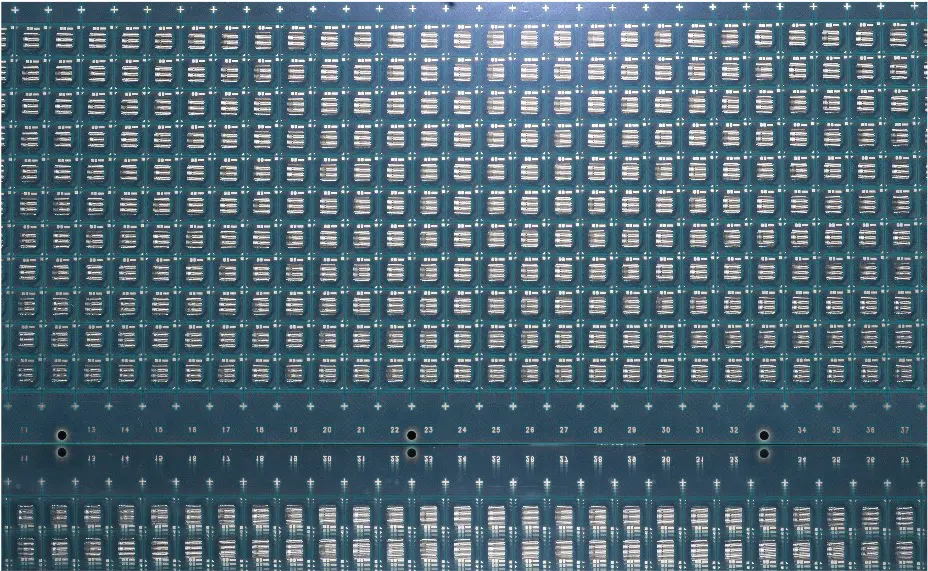
IC-substrat Stack-up och material
Stapling liknande HDI-kretskort med kärna och PP.
BT (Bismaleimide Triazine) hartsmaterial istället för FR4
BT är högre Tg. 250 till 300 °C
BT har lägre CTE XY-axel 2-5ppm/°C istället för 11-14ppm/°C för FR4.
Begränsat till stack-up 2L, 4L och 6L för standard och 1+2+1, 1+4+1, 2+2+2 för struktur.
Behöver du kretskort med IC-substrat?
Dubbelsidiga och flerlagers kretskort används ofta i en rad olika elektroniska tillämpningar som telekommunikation, industriella styrsystem och strömförsörjning. De används också för prototyper och småskalig produktion.
Tekniska data
IC-substrat
| IC Substrat Funktion | ICAPE-gruppens tekniska specifikation för IC-substrat |
|---|---|
| Antal lager | 2 till 6 skikt |
| Tekniska höjdpunkter | IC-substrat är PCB-stöd för 1 Chip-lödning genom Wire Bonding Process eller Flip Chip Process |
| Material och egenskaper | BT (Bismaleimid Triazin) |
| Bas koppar tjocklek | 0-12um beroende på metod för substratstruktur |
| Minsta spår och avstånd | 30/30 µm (avancerat 20/20 µm) |
| Tillgängliga ytbehandlingar | ENIG & ENEPIG |
| Minsta laserborrning | 50µm |
| Minsta mekaniska borrning | 100µm |
| PCB-tjocklek | 2L min. 130µm, 4L min. 210µm, 6L min. 300µm |
Frågor?
Det finns ett ICAPE Group-team nära dig och ditt företag. Våra affärsenheter runt om i världen är bemannade med lokala experter som kan svara på alla dina frågor.
Kontakta oss idag!
