Sustrato CI
Nueva generación de PCB ultra HDI
El sustrato IC, al igual que el PCB (SLP), está ampliando los límites entre la tecnología de PCB HDI y la tecnología de sustrato IC. El SLP es una parte integrada del paquete o módulo de CI que se utiliza para conectar el chip con la placa base PCB. El desarrollo de la tecnología SLP está impulsado principalmente por los sectores de la telefonía móvil y los dispositivos electrónicos portátiles, y se trata de un mercado en rápido crecimiento.
Ventajas del producto
Las principales funciones de la placa de sustrato de CI incluyen la soldadura de chips y la conexión eléctrica mediante la unión de cables o el proceso Flip chip, y garantiza la fiabilidad mediante el uso de materia prima adaptada para el alargamiento de los chips. La fiabilidad se garantiza mediante el uso de materias primas adaptadas a la elongación de los diferentes materiales durante las fases de montaje y las limitaciones climáticas.

Alta densidad
Substrate Like PCB (SLP) lleva la producción de PCB HDI a un nuevo nivel con líneas/espacios ultrafinos de hasta 30/30µm. Las hojas de ruta comunes de los fabricantes de SLP prevén alcanzar la línea/espacio 20/20 µm en 2024 y 10/10 en 2025.

Fiabilidad
La placa de circuito impreso SLP (Substrate Like PCB) utiliza un material de resina BT (triazina de bismaleimida) en lugar de FR4. El material BT tiene una Tg muy alta. 250 a 300 °C y un CET X&Y muy bajo 2-5 ppm/°C en lugar de 11-14 ppm/°C para FR4. Esto garantiza una integración muy fiable con los sustratos de CI y crea la posibilidad de crear módulos o sistemas en paquetes (SIP) con chips o componentes con diseño de alta densidad.

Rendimiento
La tecnología SLP utiliza materiales de alto rendimiento, el proceso del sustrato IC y los apilados con vías definidas por láser conocidos de la tecnología HDI para crear una placa de circuito impreso HDI muy fiable y ultracompleja.
¿Qué es el sustrato IC PCB?
Definición
Una placa de circuito impreso SLP, también conocida como placa portadora de CI, es un tipo de placa de circuito impreso diseñada específicamente para alojar chips de circuitos integrados (CI). Se trata de una placa de circuito impreso ultra HDI utilizada en la industria de semiconductores para empaquetar y conectar chips IC al resto del sistema electrónico.
La función principal de una PCB de sustrato de CI es proporcionar una plataforma física para montar e interconectar los chips de CI. El SLP suele tener de 2 a 6 capas de trazas conductoras, vías definidas por láser y almohadillas que permiten las conexiones eléctricas entre los chips de CI y la placa de circuito impreso.

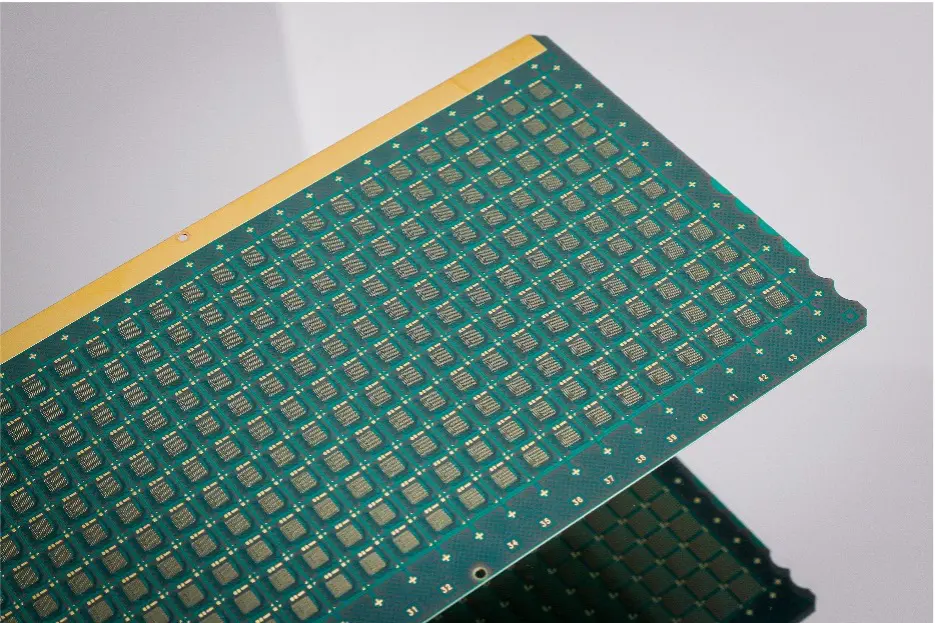
Especificaciones
Línea y espacio: 30/30 µm (avanzado 20/20 µm)
Vías: 50 µm Láser definido.
Número de capas: 2 a 6 años
Material de la PCB: Resina BT, triazina de bismaleimida
Estructura del sustrato del CI
Existen 3 métodos de proceso diferentes.
Método sustractivo – Un proceso sustractivo que utiliza láminas de cobre finas de 9–12 µm y pasos de producción basados en el método de panel tenting. 35/35 µm línea y espacio posibles.
mSAP – Un modified semi additive process: un proceso semiaditivo modificado que utiliza una lámina de cobre ultrafina de 1,5 µm, un revestimiento químico de cobre + un cobreado selectivo y un grabado selectivo. Posibilidad de línea y espacio de 20/20 µm.
SAP – Proceso semi additive process: un proceso semiaditivo que utiliza un material especial sin cobre de base y un revestimiento químico de cobre + cobreado selectivo y grabado selectivo. Posibilidad de línea y espacio de 15/15 µm (el método SAP puede crear hasta 12 capas, pero solo está disponible para la producción en serie.)

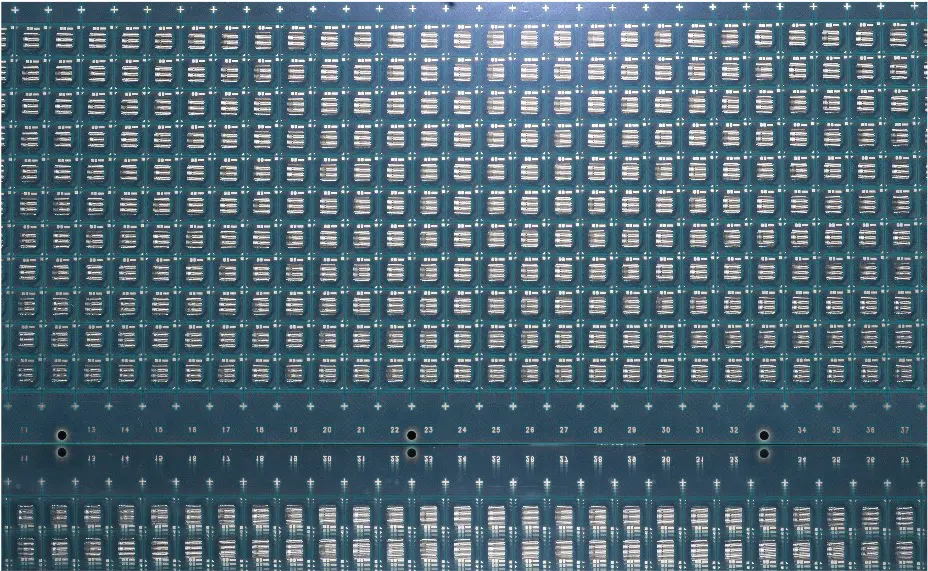
Apilado sustrato IC y material
Apilamiento similar a las placas de circuito impreso HDI con núcleo y PP.
Material de resina BT (triazina de bismaleimida) en lugar de FR4
BT es mayor Tg. 250 a 300 °C
BT es menor CTE eje XY 2-5 ppm/°C en lugar de 11-14 ppm/°C para FR4.
Limitado a apilamiento 2L, 4L y 6L para estándar y 1+2+1, 1+4+1, 2+2+2 para estructura.
¿Necesita una PCB CI?
Las PCB de doble cara y multicapa se utilizan habitualmente en una amplia gama de aplicaciones electrónicas, como en las telecomunicaciones, los sistemas de control industrial y suministro eléctrico. Además, se utilizan en la creación de prototipos y en pequeñas series de producción.
Características técnicas
Sustrato CI
| Características del sustrato IC | Especificación técnica del sustrato IC del Grupo ICAPE |
|---|---|
| Número de capas | de 2 a 6 |
| Tecnología destacada | El sustrato IC es compatible con PCB para la soldadura de 1 chip mediante el proceso Wire Bonding o el proceso Flip Chip. |
| Materiales | BT (Bismaleimida Triazina) |
| Espesor del cobre base | 0-12um dependiendo del método de estructura del sustrato |
| Pista y separación mínimas | 30/30µm (Avanzado 20/20µm) |
| Acabados superficiales disponibles | ENIG Y ENEPIG |
| Perforación láser mínima | 50µm |
| Taladro mecánico mínimo | 100µm |
| Espesor de PCB | 2L mín. 130µm, 4L mín. 210µm, 6L mín. 300µm |
¿Alguna consulta?
Un equipo ICAPE Group está cerca de usted y de su empresa. En todo el mundo, nuestras unidades de negocio cuentan con expertos nativos disponibles para responder a todas sus consultas.
¡Contacte con nosotros hoy mismo!
