Substrats IC
Nouvelle Génération de Circuits Imprimés Avancés
Les substrats de circuit intégré, comme les circuits imprimés, repoussent les limites entre la technologie de circuits imprimés d’interconnexion à haute densité et la technologie de substrats de circuit intégré. La technologie SLP (« Substrate Like PCB », ou circuit imprimé de type substrat) fait partie intégrante du module ou du boîtier du circuit intégré utilisé pour connecter la puce à la carte mère du circuit imprimé. Le développement de la technologie SLP est principalement alimenté par les industries de la téléphonie mobile et des appareils électroniques portables, et il s’agit d’un marché en pleine croissance.
Avantages du produit
Les principales fonctionnalités de la carte de substrat de circuit intégré comprennent la soudure des puces et la connexion électrique par câblage filaire ou par le processus de puce retournée. La fiabilité est garantie en utilisant des matières premières adaptées à l’allongement des differents matériaux pendant les phases d’assemblage et les contraintes climatiques.

Haute densité
La technologie SLP donne une nouvelle dimension à la production des circuits imprimés d'interconnexion à haute densité, grâce à des lignes/espaces très fins allant jusqu'à 30/30 µm. Les feuilles de route des fabricants de SLP prévoient d'atteindre des lignes/espaces de 20/20 µm en 2024 et de 10/10 en 2025.

Fiabilité
La technologie SLP s'appuie sur la résine BT (triazine de bismaléimide) au lieu du FR4. Le matériau BT présente une température de transition vitreuse très élevée de 250 à 300 °C et un très faible coefficient de dilatation thermique pour les axes X et Y de 2-5 ppm/°C, par comparaison avec 11-14 ppm/°C pour le FR4. Cela garantit une intégration très fiable avec les substrats de circuit intégré et permet de créer des modules ou des systèmes en boîtier (SIP) avec des puces ou des composants à haute densité.

Performances
La technologie SLP s'appuie sur des matériaux de haute performance, le processus des substrats de circuit intégré et les empilages avec des vias définis au laser issus de la technologie d'interconnexion à haute densité, pour créer des circuits imprimés d'interconnexion à haute densité très fiables et extrêmement complexes.
Qu'est-ce qu'un circuit imprimé de substrat de circuit intégré?
Définition
Un circuit imprimé de type substrat de circuit intégré (SLP), également connu sous le nom de carte porteuse de circuit intégré, est un type de carte de circuit imprimé spécifiquement conçu pour accueillir des puces de circuits intégrés. Il s’agit d’un circuit imprimé d’interconnexion à ultra-haute densité utilisé dans l’industrie des semi-conducteurs pour mettre sous boîtier et connecter les puces de circuit intégré au reste du système électronique.
La fonction principale d’un circuit imprimé de substrat de circuit intégré est de fournir une plateforme physique pour le montage et l’interconnexion des puces de circuit intégré. La technologie SLP comporte généralement 2 à 6 couches de traces conductrices, de vias définis au laser et de pastilles qui permettent d’établir des connexions électriques à la fois entre les puces de circuit intégré et le circuit imprimé.

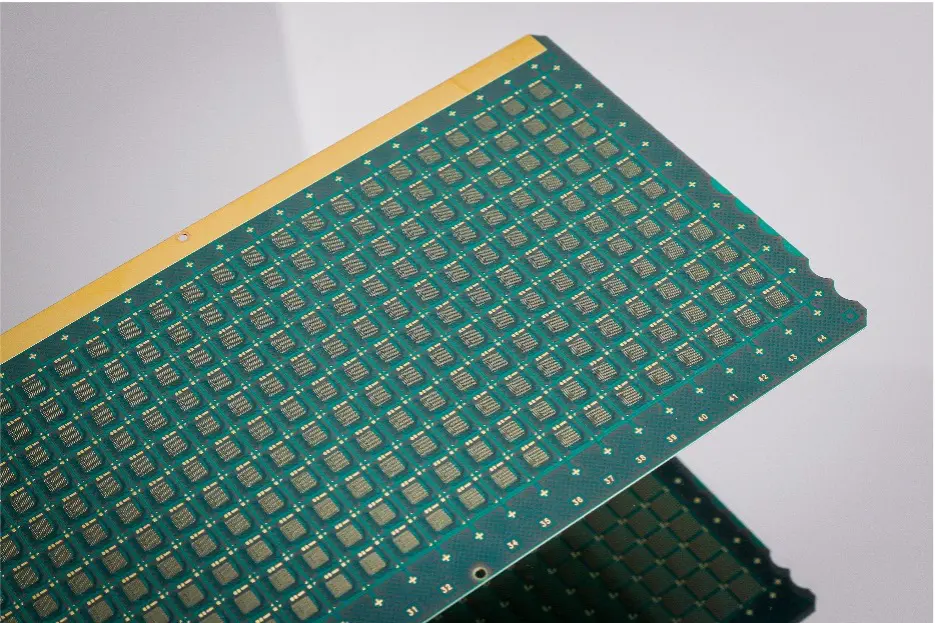
Spécifications
Lignes et espace : 30/30 µm (modèles avancés : 20/20 µm)
Vias : 50 µm, définis au laser.
Nombre de couches : 2 à 6
Matériau du circuit imprimé : résine BT (triazine de bismaléimide)
Structure du substrat de circuit intégré
Il existe trois méthodes de production différentes.
Méthode soustractive : un processus soustractif utilisant des feuilles de cuivre fines de 9–12 µm et des étapes de production s’appuyant sur la méthode panel tenting.
mSAP (modified semi additive process): un procédé semi-additif modifié utilisant une feuille de cuivre ultra-mince de 1,5 µm, un placage chimique de cuivre + un cuivrage sélectif et une gravure sélective.
SAP (semi additive process) : un procédé semi-additif utilisant un matériau spécial sans cuivre de base et un placage chimique de cuivre + cuivrage sélectif et gravure sélective. Possibilité de lignes et d’espaces de 15/15 µm. (La méthode SAP permet de créer jusqu’à 12 couches, mais elle n’est disponible que pour la production de masse.)

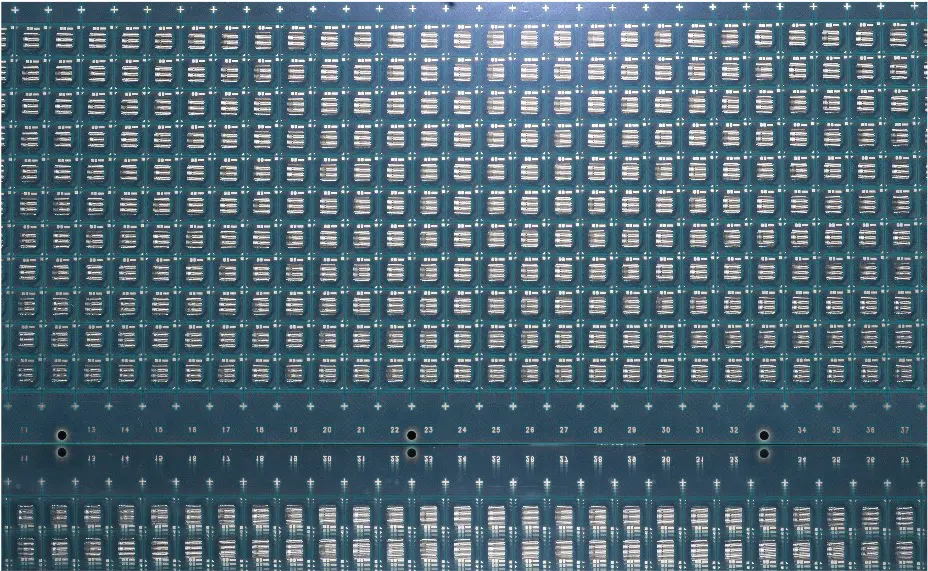
Matériaux et empilage des substrats de circuit intégré
Empilage similaire aux circuits imprimés HDI avec core et PP.
Résine BT (triazine de bismaléimide) au lieu de FR4
La résine BT présente une température de transition vitreuse plus élevée de 250 à 300 °C
La résine BT offre un coefficient de dilatation thermique plus faible pour les axes X et Y de 2-5 ppm/°C, par rapport à 11-14 ppm/°C pour le FR4.
Limité à l’empilage de 2, 4 et 6 couches pour la version standard et 1+2+1, 1+4+1, 2+2+2 pour la structure.
Avez-vous besoin de circuits imprimés de substrats de circuits intégrés ?
Les circuits imprimés double face et multicouches sont couramment utilisés dans une large gamme d’applications électroniques, telles que les télécommunications, les systèmes de contrôle industriel et les alimentations électriques. Ils servent également pour le prototypage et la production à petite échelle.
Données techniques
Substrats de circuit intégré
| Caractéristiques du substrat IC | Spécification technique du substrat IC du groupe ICAPE |
|---|---|
| Nombre de couches | de 2 à 6 |
| Points forts de la technologie | Le substrat IC est un support PCB pour la soudure d'une puce par le procédé Wire Bonding ou Flip Chip. |
| Matériaux | BT (Bismaléimide Triazine) |
| Épaisseur du cuivre de base | 0-12um en fonction de la méthode de structure du substrat |
| Voie et espacement minimums | 30/30µm (avancé 20/20µm) |
| Finitions de surface disponibles | ENIG & ENEPIG |
| Perçage laser minimum | 50µm |
| Perçage mécanique minimum | 100µm |
| Épaisseur du circuit imprimé | 2L min. 130µm, 4L min. 210µm, 6L min. 300µm |
Des questions ?
Vous trouverez toujours une équipe d’ICAPE Group à proximité de vous et de votre entreprise. Partout dans le monde, nos unités commerciales sont dotées d’experts locaux, à votre disposition pour répondre à toutes vos questions.
Contactez-nous dès aujourd’hui !
